
Студопедия КАТЕГОРИИ: АвтоАвтоматизацияАрхитектураАстрономияАудитБиологияБухгалтерияВоенное делоГенетикаГеографияГеологияГосударствоДомЖурналистика и СМИИзобретательствоИностранные языкиИнформатикаИскусствоИсторияКомпьютерыКулинарияКультураЛексикологияЛитератураЛогикаМаркетингМатематикаМашиностроениеМедицинаМенеджментМеталлы и СваркаМеханикаМузыкаНаселениеОбразованиеОхрана безопасности жизниОхрана ТрудаПедагогикаПолитикаПравоПриборостроениеПрограммированиеПроизводствоПромышленностьПсихологияРадиоРегилияСвязьСоциологияСпортСтандартизацияСтроительствоТехнологииТорговляТуризмФизикаФизиологияФилософияФинансыХимияХозяйствоЦеннообразованиеЧерчениеЭкологияЭконометрикаЭкономикаЭлектроникаЮриспунденкция |
Распыление ионной бомбардировкой
Термическое вакуумное напыление имеет ряд недостатков и ограничений, главные из которых следующие: - напыление плёнок из тугоплавких материалов (W, Mo, SiO2, Al2O3 и др.) требует высоких температур на испарителе, при которых неизбежно загрязнение потока материалом испарителя; - при напылении сплавов различие в скорости испарения отдельных компонентов приводит к изменению состава плёнки по сравнению с исходным составом материала, помещённого в испаритель; - инерционность процесса, требующая введения в рабочую камеру заслонки с электромагнитным приводом; - неравномерность толщины плёнки, вынуждающая применять устройства перемещения подложек и корректирующие диафрагмы. Первые три недостатка обусловлены необходимостью высокотемпературного нагрева вещества, а последний - высоким вакуумом в рабочей камере. Принцип действия устройств ионного распыления основан на таких физических явлениях, как ионизация частиц газа, тлеющий разряд в вакууме и распыление веществ бомбардировкой ускоренными ионами. Ионизация – это процесс превращения нейтральных частиц газа (атомов и молекул) в положительно заряженные ионы. Сущность этого процесса состоит в следующем. Находящийся между двумя электродами газ всегда содержит несколько свободных электронов. Если между электродами анодом и катодом – создать электрическое поле, это поле будет ускорять свободные электроны. При встрече с нейтральной частицей газа ускоренный первичный электрон выбивает из нее вторичный электрон, превращая нейтральную частицу газа в положительно заряженный ион. Т.о., в результате столкновения появляется новая пара заряженных частиц: выбитый вторичный электрон и положительно заряженный ион.  Отраженный первичный электрон и вторичный электрон, в свою очередь, могут быть ускорены электрическим полем и при взаимодействии с нейтральными частицами газа образовать по паре заряженных частиц. Так развивается лавинообразный процесс появления в газовой среде двух видов заряженных частиц, и газ, будучи в нормальных условиях электрическим изолятором, становится проводником. Современные представления о процессе взаимодействия, приводящего к распылению, предполагают, что в результате проникновения иона в материал возникает каскад бинарных упругих столкновений смещенных атомов, в которых происходит обмен энергией и импульсом между атомами. Средне время развития каскада столкновений порядка 2·10-13с. Конечным результатом каскада столкновений может стать передача поверхностному атому (в слое толщиной ~1 нм) достаточной энергии и необходимого импульса нужной направленности (в направлении границы твердое тело-вакуум) для преодоления сил его связи на поверхности, что и приводит к распылению. Процесс распыления ионной бомбардировкой является "холодным" процессом, т.к. атомарный поток вещества на подложку создаётся путём бомбардировки поверхности твёрдого образца (мишени) ионами инертного газа и возбуждения поверхности атомов до энергии, превышающей энергию связи с соседними атомами. Необходимый для этого поток ионов создаётся в электрическом газовом разряде, для чего давление газа в рабочей камере должно быть в пределах 0,1Ч10 Па, т.е. на несколько порядков более высокое, чем в камере установки термовакуумного напыления. Последнее обстоятельство приводит к рассеиванию потока атомов с мишени и повышению равномерности толщины осаждаемых плёнки до ±1% , причём без применения дополнительных устройств. Метод ионного распыления основан на бомбардировке мишени, изготовленной из осаждаемого материала, быстрыми частицами. Выбитые из мишени в результате бомбардировки частицы образуют поток наносимого материала, который осаждается в виде тонкой пленки на подложках, расположенных на некотором расстоянии от мишени. Важным фактором, определяющим эксплуатационные особенности и конструкции установок ионного распыления, является способ генерации ионов, бомбардирующих мишень. В соответствии с этим установки ионного распыления оснащаются простой двухэлектродной или магнетронной системой.
Катодное распыление
Катодное распыление - одна из разновидностей распыления ионной бомбардировкой постепенно вытесняется более совершенными процессами высокочастотного и магнетронного распыления. Однако, будучи относительно простым и в то же время содержащим все основные черты этой группы процессов, оно представляет собой наиболее удобную форму для изучения процессов этого вида распыления вообще. На рис. 4 представлена схема рабочей камеры установки катодного распыления. Основными элементами камеры являются: 1 - анод с размещенными на нём подложками; 2 - игольчатый натекатель, обеспечивающий непрерывную подачу аргона; 3 - катод - мишень из материала, подлежащего распылению и осаждению; 4 - вакуумный колпак из нержавеющей стали; 5 - экран, охватывающий катод с небольшим зазором и предотвращающий паразитные разряды на стенки камеры; 6 - постоянный электромагнит, удерживающий электроны в пределах разрядного столба; 7 - герметизирующая прокладка. Питание осуществляется постоянным напряжением, нижний электрод с подложками заземлён и находится под более высоким потенциалом, чем катод-мишень. Переменная нагрузка служит для регулирования тока разряда. На рис.5 представлена упрощённая структура разряда и распределение потенциала вдоль разряда, а также типы частиц, участвующих в процессе.
Режимы катодного распыления. На рис.6а приведена вольтамперная характеристика разряда. При подаче постоянного напряжения в несколько киловольт происходит пробой межэлектродного промежутка, быстрое нарастание тока и падение напряжения в разряде (область зажигания разряда I). При увеличении тока разряда за счёт уменьшения сопротивления Rн площадь катода-мишени, покрытая разрядом, возрастает, плотность разрядного тока и напряжение на разряде остаются постоянными и невысокими, а скорость распыления мала (область нормально тлеющего разряда II). В области III вся площадь мишени покрыта разрядом, и увеличение разрядного тока приводит к повышению плотности разрядного тока, напряжения на разряде и скорости распыления. Область Ш, называемая областью аномально тлеющего разряда, используется в качестве рабочей области в процессах катодного распыления. Для предотвращения перехода в область дугового разряда (область IV) предусмотрены интенсивное водяное охлаждение мишени и ограничение источника питания по мощности. На рис. 6,б выделена рабочая область III ВАХ. Крутизна характеристики в этой области зависит от давления рабочего газа, в нашем случае аргона. Рабочая точка, характеризующая режимы обработки - давление газа Р, ток Jp и напряжение Up разряда, лежит на нагрузочной характеристике источника питания
где Uп - напряжение питания. С другой стороны, скорость распыления мишени W г/см2Чс
где С - коэффициент, характеризующий род распыляемого материала и род рабочего газа; Uнк - нормальное катодное падение напряжения (область II ВАХ); jp - плотность разрядного тока; dTП - ширина тёмного катодного пространства. Из (2.2) следует, что максимальная скорость распыления достигается при максимальной мощности, выделяемой в разряде. Согласно нагрузочной характеристике (2.1)
Максимум этой функции определяет оптимальные значения тока Jp0 и напряжения Uр0:
При этом однозначно определяется оптимальное значение давления рабочего газа. Выбор значений Un и Rн должен, как было сказано, предотвращать переход в область дугового разряда, при котором наблюдается выброс с мишени крупных частиц и осаждение тонкой, однородной по толщине плёнки становится невозможным.
Магнетронное распыление
К ограничениям и недостаткам процесса катодного распыления относятся: - возможность распыления только проводящих материалов, способных эмитировать в разряд электроны, ионизирующие молекулы аргона и поддерживающие горение разряда; - малая скорость роста плёнки (единицы нм/с) из-за значительного рассеивания распыляемых атомов материала в объёме рабочей камеры. Разновидность методов на основе тлеющего разряда является магнетронное распыление. Магнетронные системы ионного распыления относятся к системам распыления диодного типа, в которых атомы распыляемого материала удаляются с поверхности мишени при ее бомбардировке ионами рабочего газа (обычно аргона), образующимися в плазме аномального тлеющего разряда. Для увеличения скорости распыления необходимо увеличить интенсивность ионной бомбардировки мишени, т. е. плотность ионного тока на поверхности мишени. С этой целью используют магнитное поле В, силовые линии которого параллельны распыляемой поверхности и перпендикулярны силовым линиям электрического поля Е. Катод (мишень) помещен в скрещенное электрическое (между катодом и анодом) и магнитное поле, создаваемое магнитной системой. Наличие магнитного поля у распыляемой поверхности мишени позволяет локализовать плазму аномального тлеющего разряда непосредственно у мишени. Дуги силовых линий В замыкаются между полюсами магнитной системы. Поверхность мишени, расположенная между местами входа и выхода силовых линий В и интенсивно распыляемая, имеет вид замкнутой дорожки, геометрия которой определяется формой полюсов магнитной системы. При подаче постоянного напряжения между мишенью (отрицательный потенциал) и анодом (положительный или нулевой потенциал) возникает неоднородное электрическое поле и возбуждается аномальный тлеющий разряд. Эмиттированные с катода под действием ионной бомбардировки электроны захватываются магнитным полем и оказываются как бы в ловушке, создаваемой, с одной стороны, магнитным полем, возвращающим электроны на катод, а с другой стороны – поверхность мишени, отталкивающей электроны. В результате электроны совершают сложное циклоидальное движение у поверхности катода. В процессе этого движения электроны претерпевают многочисленные столкновения с атомами аргона, обеспечивая высокую степень ионизации, что приводит к увеличению интенсивности ионной бомбардировки мишени и соответственно значительному возрастанию скорости распыления. Основные параметры магнетронных систем ионного распыления:
- удельная скорость распыления – (4-40)·10-5 г/(см2·с); - эффективность процесса генерации (по меди) - 3·10-6 г/Дж; - энергия генерируемых частиц – 10-20 эВ; - энергия осаждаемых частиц – 0,2-10,0 эВ; - скорость осаждения 10-60 нм/c; - рабочее давление – (5-50)·10-2 Па. К основным достоинствам магнетронных распылительных систем следует отнести: - высокие скорости распыления при низких рабочих напряжениях (≈500 В) и небольших давлениях рабочего газа; - низкие радиационные дефекты и отсутствие перегрева подложек; - малую степень загрязненности пленок посторонними газовыми включениями; - возможность получения равномерных по толщине пленок на большой площади подложек.
Высокочастотное распыление
Высокочастотное распыление начали применять, когда потребовалось наносить диэлектрические. Металлы и полупроводниковые материалы обычно распыляют при постоянном напряжении на мишени. Если материал мишени является диэлектриком, то при постоянном напряжении на электроде мишени распыление быстро прекращается, так как поверхность диэлектрика при ионной бомбардировке приобретает положительный потенциал, после чего отражает практически все положительные ионы. Для осуществления процесса распыления диэлектрика необходимо периодически нейтрализовать положительный заряд на нем. С этой целью к металлической пластине, расположенной непосредственно за распыляемой диэлектрической мишенью, прикладывают ВЧ-напряжение с частотой 1-20 МГц (наибольшее распространение для ВЧ-распыления получила частота 13,56 МГц, разрешенная для промышленного применения). При отрицательной полуволне напряжения на диэлектрической мишени (катоде) происходит обычное катодное распыление. В этот период поверхность мишени заряжается положительными ионами, вследствие чего прекращается ионная бомбардировка мишени. При положительной полуволне напряжения происходит бомбардировка мишени электронами, которые нейтрализуют положительный заряд на поверхности мишени, позволяя производить распыление в следующем цикле. Основные параметры, достижимые в установках ВЧ-распыления материалов:
- удельная скорость распыления - 2·10-7 - 2·10-6 г/(см2·с); - эффективность процесса распыления (по меди) - 6·10-7 г/Дж; - энергия генерируемых частиц – 10-200 эВ; - скорость осаждения – 0,3-3,0 нм/с; - энергия осаждаемых частиц – 0,2-20 эВ; - рабочее давление в камере установки – 0,5-2,0 Па.
|
||
|
Последнее изменение этой страницы: 2018-04-12; просмотров: 602. stydopedya.ru не претендует на авторское право материалов, которые вылажены, но предоставляет бесплатный доступ к ним. В случае нарушения авторского права или персональных данных напишите сюда... |

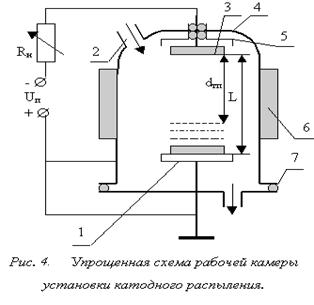
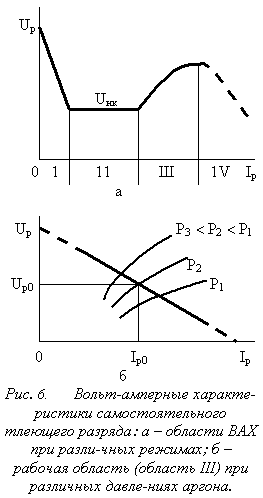
 (2.1)
(2.1) (2.2)
(2.2) (2.3)
(2.3) .
. 