
Студопедия
АвтоАвтоматизацияАрхитектураАстрономияАудитБиологияБухгалтерияВоенное делоГенетикаГеографияГеологияГосударствоДомЖурналистика и СМИИзобретательствоИностранные языкиИнформатикаИскусствоИсторияКомпьютерыКулинарияКультураЛексикологияЛитератураЛогикаМаркетингМатематикаМашиностроениеМедицинаМенеджментМеталлы и СваркаМеханикаМузыкаНаселениеОбразованиеОхрана безопасности жизниОхрана ТрудаПедагогикаПолитикаПравоПриборостроениеПрограммированиеПроизводствоПромышленностьПсихологияРадиоРегилияСвязьСоциологияСпортСтандартизацияСтроительствоТехнологииТорговляТуризмФизикаФизиологияФилософияФинансыХимияХозяйствоЦеннообразованиеЧерчениеЭкологияЭконометрикаЭкономикаЭлектроникаЮриспунденкция
|
Принцип действия транзистора и его основные параметры
Слайд 1
Лекция 3.
Биполярные транзисторы.
Транзистор, или полупроводниковый триод, являясь управляемым элементом, нашел широкое применение в схемах усиления, а также в импульсных схемах. Отсутствие накала, малые габариты и стоимость, высокая надежность — таковы преимущества, благодаря которым транзистор вытеснил из большинства областей техники электронные лампы.
Слайд 2
Биполярный транзистор представляет собой трехслойную полупроводниковую структуру с чередующимся типом электропроводности слоев и содержит два p-n-перехода. В зависимости от чередования слоев существуют транзисторы типов р-n-р и n-р-n (рис. 4.1, а, б). Их условное обозначение на электронных схемах показано на рис. 4.1, в, г. В качестве исходного материала для получения трехслойной структуры используют германий и кремний (германиевые и кремниевые транзисторы).
Трехслойная транзисторная структура создается по сплавной или диффузионной технологии, по которой выполняется и двухслойная p-n-структура полупроводниковых диодов. Трехслойная транзисторная структура типа р-n-р, выполненная по сплавной технологии, показана на рис. 4.1, д. Пластина полупроводника «типа является основанием, базой (отсюда и название слоя) конструкции. Два наружных р-слоя создаются в результате диффузии в них акцепторной примеси при сплавлении с соответствующим материалом. Один из слоев называется эмиттерным, а другой — коллекторным. Так же называются и p-n-переходы, создаваемые этими слоями со слоем базы, а также внешние выводы от этих слоев.
 Риc. 4.1. Полупроводниковая структура транзисторов типов p-n-р (а) и n-p-п (б); Риc. 4.1. Полупроводниковая структура транзисторов типов p-n-р (а) и n-p-п (б);
их условные обозначения в электронных схемах (в, г); сплавная транзисторная структура типа р-п-р (д);
пример конструктивного исполнения маломощного транзистора (е):
1 — донце корпуса;
2 — колба;
3 — внутренний вывод эмиттера;
4 — таблетка индия;
5 — кристаллодержатель;
6 — пластина германия n-типа;
7 — таблетка индия;
8 —внутренний вывод коллектора; 9 — стеклянный изолятор
Слайд 3
Функция эмиттерного перехода — инжектирование (эмиттирование) носителей заряда в базу, функция коллекторного перехода — сбор носителей заряда, прошедших через базовый слой. Чтобы носители заряда, инжектируемые эмиттером и проходящие через базу, полнее собирались коллектором, площадь коллекторного перехода делают больше площади эмиттерного перехода. Пример конструктивного исполнения маломощного транзистора показан на рис. 4.1, е.
В транзисторах типа n-р-n функции всех трех слоев и их названия аналогичны, изменяется лишь тип носителей заряда, проходящих через базу: в приборах типа р-n-р — это дырки, в приборах типа n-р-n — электроны.
Слайд 4.1
Принцип действия транзистора и его основные параметры
Принцип действия биполярного транзистора рассмотрим на примере структуры типа р-п-р (рис. 4.2, а). Сначала покажем распределение концентрации носителей заряда в слоях транзисторной структуры и разности потенциалов, создаваемой объемными зарядами p-n-переходов, в отсутствие внешних напряжений (рис. 4.2, б, в).

Рис. 4.2. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б) и внутренней разности потенциалов (в) в отсутствие внешних напряжений
Обозначение концентраций основных и неосновных носителей заряда здесь то же, что и для диода. Индекс «0» в обозначениях указывает на распределение концентраций в слоях в отсутствие внешних напряжений. Соотношение концентраций основных носителей заряда в эмиттерном и коллекторном слоях транзистора несущественно, и на рис. 4.2, б они приняты одинаковыми. Отличие же в концентрациях основных носителей заряда эмиттерного и базового слоев весьма важно, так как оно влияет (что будет показано в дальнейшем) на параметры транзистора, в частности на коэффициент передачи тока α. Концентрация основных носителей заряда в базе должна быть много меньше концентрации основных носителей заряда в эмиттере, т.е. ppo >> nno. Таким образом, для транзистора базовый слой должен быть более высокоомным, чем эмиттерный. Это достигается за счет использования высокоомного исходного полупроводника n-типа. С учетом того, что для определенной температуры произведение рn — величина постоянная, полная картина распределения концентраций в слоях транзистора будет иметь вид, показанный на рис. 4.2, б.
Слайд 4.2
В отсутствие внешних напряжений на границах раздела трех слоев образуются объемные заряды, создается внутреннее электрическое поле и между слоями действует внутренняя разность потенциалов. Потенциальный барьер в каждом из переходов устанавливается такой величины, чтобы обеспечивалось равновесие диффузионного и дрейфового потоков носителей заряда, движущихся через переходы в противоположных направлениях, т.е. равенство нулю протекающего через них тока. Поскольку концентрации основных (и неосновных) носителей заряда в эмиттерном и коллекторном слоях приняты одинаковыми, потенциальные барьеры в обоих p-n-переходах будут равны. Если за нулевой уровень отсчета принять потенциал базы, то распределение разности потенциалов в транзисторе в отсутствие внешних напряжений будет иметь вид, показанный на рис. 4.2, в.
Слайд 5
Внешние напряжения подключают к транзистору таким образом, чтобы обеспечивалось смещение эмиттерного перехода в прямом направлении, а коллекторного перехода — в обратном направлении.
Слайд 6
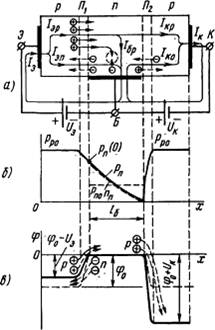
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Слайд 7(1)
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
| Это достигается с помощью двух источников напряжения Uэ и Uк (рис. 4.3, а). Напряжение Uэ подключается положительным полюсом к эмиттеру относительно базы, напряжение Uк — отрицательным полюсом к коллектору относительно базы (схема с общей базой).
Рассмотрим процессы, протекающие в эмиттерном переходе, базовом слое и коллекторном переходе транзистора.
Так как в эмиттерном переходе внешнее напряжение Uэ действует в прямом направлении, потенциальный барьер для дырок — основных носителей зарядов эмиттерного слоя — уменьшается и дырки из эмиттера под действием диффузии будут в большем количестве переходить (инжектировать) в область базы (рис. 4.3, а, в). Аналогичным образом увеличится диффузионный поток электронов (основных носителей заряда области базы) в эмиттер. С учетом достаточно малой для смещенного в прямом направлении p-n-перехода составляющей дрейфового тока, создаваемой неосновными носителями заряда областей, ток эмиттерного перехода и цепи эмиттера можно записать в виде
Iэ = Iэр + Iэn.
Дырочная составляющая тока Iэр создается потоком дырок, переходящих из эмиттера в базу. Большинство дырок в последующем достигает коллектора и вызывает коллекторный ток транзистора. Электронная составляющая тока Iэn обусловлена движением электронов из базы в эмиттер. Она замыкается по входной цепи через источник Uэ и не используется полезно (для создания тока в коллекторной цепи). Таким образом, функция эмиттерного перехода и процессы в эмиттерном переходе сводятся к инжекции носителей заряда (дырок) в базу.
|
Слайд 7(2)
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
| Одним из важнейших показателей эмиттерного перехода является так называемый коэффициент инжекции γ, показывающий, какую часть от полного эмиттерного тока составляет его дырочная составляющая:
γ = Iэр / Iэ. (4.2)
С точки зрения качества эмиттерного перехода необходимо, чтобы электронная составляющая эмиттерного тока Iэn была существенно меньше его дырочной составляющей Iэр. Это достигается значительным (на два-три порядка) превышением концентрации основных носителей заряда (дырок) в эмиттере над концентрацией основных носителей заряда (электронов) в базе (рp0 >> nn0).
Как указывалось, задача решается применением высокоомного исходного полупроводника для создания базового слоя и введением большой концентрации акцепторной примеси для получения эмиттерного слоя. Для выпускаемых промышленностью транзисторов коэффициент инжекции γ = 0,97÷ 0,995.
|
Слайд 8(1)
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
| Процессы в базовом слое определяются в основном поведением дырок, перешедших в базу через эмиттерный переход. Инжектируемые дырки, попадая в базовый слой, повышают концентрацию дырок в базе вблизи эмиттера по сравнению с равновесной концентрацией рn0 (рис. 4.3, б). На границе с эмиттерным переходом создается концентрация дырок рn(0). Величину этой концентрации, зависящей от подведенного напряжения Uэ, находят из соотношения, аналогичного для диода:
 Под действием концентрации рn(0) развивается диффузионное движение дырок в базе в сторону коллектора, т.е. в направлении меньшей концентрации. Концентрация дырок в базе на границе с коллекторным переходом устанавливается близкой к нулю, так как дошедшие до коллекторного перехода под действием диффузии дырки ускоряются полем перехода и перебрасываются в коллектор. Установившееся при определенном напряжении Uэ (определенном токе эмиттера и соответствующей величине рn(0)) распределение концентрации дырок в базе показано на рис. 4.3, б.
Ввиду относительно малой толщины базового слоя lб (соизмеримой с диффузионной длиной дырок Lp) закон распределения концентрации дырок в базе при диффузии рn(х) близок к линейному. Градиент концентрации дырок в базе определяет диффузионный ток дырок в ней в направлении коллекторного перехода.
Описанный характер движения дырок в базе возможен только тогда, когда количество находящихся в объеме базы дырок равно количеству электронов, а распределения их концентраций близки (объемный заряд дырок скомпенсирован объемным зарядом электронов), т.е. при условии электрической нейтральности базы.
Под действием концентрации рn(0) развивается диффузионное движение дырок в базе в сторону коллектора, т.е. в направлении меньшей концентрации. Концентрация дырок в базе на границе с коллекторным переходом устанавливается близкой к нулю, так как дошедшие до коллекторного перехода под действием диффузии дырки ускоряются полем перехода и перебрасываются в коллектор. Установившееся при определенном напряжении Uэ (определенном токе эмиттера и соответствующей величине рn(0)) распределение концентрации дырок в базе показано на рис. 4.3, б.
Ввиду относительно малой толщины базового слоя lб (соизмеримой с диффузионной длиной дырок Lp) закон распределения концентрации дырок в базе при диффузии рn(х) близок к линейному. Градиент концентрации дырок в базе определяет диффузионный ток дырок в ней в направлении коллекторного перехода.
Описанный характер движения дырок в базе возможен только тогда, когда количество находящихся в объеме базы дырок равно количеству электронов, а распределения их концентраций близки (объемный заряд дырок скомпенсирован объемным зарядом электронов), т.е. при условии электрической нейтральности базы.
|
Слайд 8(2)
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
| Электроны, компенсирующие объемный заряд дырок, поступают по цепи базы одновременно с дырками, входящими в слой базы сразу же после подключения напряжений Uэ и Uк. В установившемся режиме концентрации дырок рn и электронов nn близки. Распределение концентрации электронов на рис. 4.3, б показано пунктирной кривой.
Наличие дырок и электронов в базе приводит к тому, что в процессе диффузии некоторая часть дырок рекомбинирует с электронами (рис. 4.3, а). В результате актов рекомбинации количество дырок, дошедших до коллектора, не будет равно количеству дырок, поступивших из эмиттера, и, следовательно, дырочная составляющая коллекторного тока Iкp будет меньше дырочной составляющей эмиттерного тока Iэр. Вследствие рекомбинации некоторого числа дырок с электронами в процессе их движения через базу концентрация дырок уменьшается, что приводит к уменьшению их градиента концентрации по оси х и некоторому отличию кривой рn(х) от линейного закона (рис. 4.3, б).
Вместе с тем акты рекомбинации дырок с электронами создают недостаток электронов, требующихся для компенсации дырок, постоянно входящих в базу из эмиттера. Необходимые электроны поступают по цепи базы, создавая базовый ток транзистора Iбр (рис. 4.3, а). Следовательно, разность между дырочными составляющими эмиттерного и коллекторного токов представляет собой ток базы, обусловленный рекомбинацией в ней дырок. В соответствии с этим запишем соотношение для дырочных составляющих токов транзистора:
Iэр = Iкp + Iбр.
|
Слайд 8(3)
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
| Для определения части дырок, прошедшей из эмиттера в коллектор, вводят коэффициент переноса дырок в базе δ, который равен отношению дырочной составляющей коллекторного тока к дырочной составляющей эмиттерного тока:
δ = Iкр / Iэр. (4.5)
Желательно, чтобы величина коэффициента переноса δ как можно меньше отличалась от единицы. Способы приближения к единице коэффициента перноса δ направлены на сокращение потерь дырок в базе за счет актов рекомбинации. Это достигается увеличением времени жизни дырок в базе и сокращением времени их нахождения в базе. Сокращение времени нахождения дырок в базе связано с уменьшением толщины базового слоя lб и увеличением скорости их прохождения через базу. Последнее используется в так называемых дрейфовых транзисторах путем создания в слое базы ускоряющего поля. Типовые значения коэффициента δ для транзисторов лежат в пределах 0,96—0,996.
δ=0,96—0,996
|
Слайд 9
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
| Коллекторного p-n-перехода, предназначенного для перевода дырок, достигших этого перехода, в коллекторную область (рис. 4.3, в).
Коллекторный ток транзистора Iк, обусловленный дырочной составляющей Iкp (рис. 4.3, а), связан с током эмиттера Iэ коэффициентом передачи тока α:
α = Iкр / Iэ. (4.6)
Умножив числитель и знаменатель равенства (4.6) на Iэр, получим
  Следовательно, коэффициент передачи тока α тем ближе к 1, чем меньше отличаются от 1 коэффициент инжекции γ и коэффициент переноса δ. Способы приближения к 1 коэффициента передачи тока α связаны со способами увеличения коэффициентов γ и δ (увеличение разности концентраций основных носителей заряда в слоях эмиттера и базы, увеличение времени жизни дырок в базе, уменьшение ширины базового слоя, создание ускоряющего поля в слое базы).
Наличие коллекторного перехода, включенного в обратном направлении, приводит к появлению дополнительной неуправляемой составляющей тока коллектора, обусловленной протеканием обратного тока коллекторного перехода Iк0 (рис. 4.3, а). Как известно, обратный ток создается дрейфом неосновных носителей заряда из близлежащих областей обратно включенного p-n-перехода, в данном случае концентрациями дырок рn0 в базе и электронов nр0 в коллекторе (см. рис. 4.2, б).
Поскольку концентрации неосновных носителей заряда зависят от температуры, величина обратного тока также зависит от нее, поэтому этот ток часто называют тепловым. От величины тока эмиттера ток Iк0 не зависит.
Следовательно, коэффициент передачи тока α тем ближе к 1, чем меньше отличаются от 1 коэффициент инжекции γ и коэффициент переноса δ. Способы приближения к 1 коэффициента передачи тока α связаны со способами увеличения коэффициентов γ и δ (увеличение разности концентраций основных носителей заряда в слоях эмиттера и базы, увеличение времени жизни дырок в базе, уменьшение ширины базового слоя, создание ускоряющего поля в слое базы).
Наличие коллекторного перехода, включенного в обратном направлении, приводит к появлению дополнительной неуправляемой составляющей тока коллектора, обусловленной протеканием обратного тока коллекторного перехода Iк0 (рис. 4.3, а). Как известно, обратный ток создается дрейфом неосновных носителей заряда из близлежащих областей обратно включенного p-n-перехода, в данном случае концентрациями дырок рn0 в базе и электронов nр0 в коллекторе (см. рис. 4.2, б).
Поскольку концентрации неосновных носителей заряда зависят от температуры, величина обратного тока также зависит от нее, поэтому этот ток часто называют тепловым. От величины тока эмиттера ток Iк0 не зависит.
|
Слайд 10
На рис. 4.4 дана наглядная картина протекания токов через транзистор в рассматриваемой схеме.

В соответствии с изложенным ток эмиттера Iэ равен сумме дырочной Iэр и электронной Iэn составляющих: Iэ = Iэр + Iэn.
Ток коллектора Iк состоит из дырочной составляющей Iкр и теплового тока Iк0 (Iк = Iкр + Iк0). Ток базы Iб равен алгебраической сумме электронной составляющей тока эмиттера Iэn, рекомбинационной дырочной составляющей Iбр и теплового тока Iк0
(Iб = Iэn + Iбр – Iк0).
Управляющее свойство транзистора, характеризующее изменение выходного (коллекторного) тока Iк под действием подводимого входного тока Iэ (или напряжения Uэ), обусловливается изменением дырочной составляющей коллекторного тока Iкp за счет изменения дырочной составляющей эмиттерного тока Iэр (рис. 4.4). Таким образом, принцип действия биполярного транзистора основан на создании транзитного (проходящего) потока носителей заряда из эмиттера в коллектор через базу и управлении коллекторным (выходным) током за счет изменения эмиттерного (входного) тока. Следовательно, биполярный транзистор управляется током.
Основное соотношение для токов транзистора составляется по первому закону Кирхгофа:
Iэ = Iк + Iб. (4.8)
С учетом теплового тока Iк0 и соотношения (1.21) токи Iк и Iб можно выразить через Iэ:
Iк = αIэ + Iк0. (4.9)
Iб = (1 – α) Iэ – Iк0 (4.10)
Слайд 11
|


 Риc. 4.1. Полупроводниковая структура транзисторов типов p-n-р (а) и n-p-п (б);
Риc. 4.1. Полупроводниковая структура транзисторов типов p-n-р (а) и n-p-п (б); 
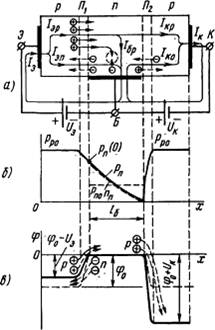
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
 Под действием концентрации рn(0) развивается диффузионное движение дырок в базе в сторону коллектора, т.е. в направлении меньшей концентрации. Концентрация дырок в базе на границе с коллекторным переходом устанавливается близкой к нулю, так как дошедшие до коллекторного перехода под действием диффузии дырки ускоряются полем перехода и перебрасываются в коллектор. Установившееся при определенном напряжении Uэ (определенном токе эмиттера и соответствующей величине рn(0)) распределение концентрации дырок в базе показано на рис. 4.3, б.
Ввиду относительно малой толщины базового слоя lб (соизмеримой с диффузионной длиной дырок Lp) закон распределения концентрации дырок в базе при диффузии рn(х) близок к линейному. Градиент концентрации дырок в базе определяет диффузионный ток дырок в ней в направлении коллекторного перехода.
Описанный характер движения дырок в базе возможен только тогда, когда количество находящихся в объеме базы дырок равно количеству электронов, а распределения их концентраций близки (объемный заряд дырок скомпенсирован объемным зарядом электронов), т.е. при условии электрической нейтральности базы.
Под действием концентрации рn(0) развивается диффузионное движение дырок в базе в сторону коллектора, т.е. в направлении меньшей концентрации. Концентрация дырок в базе на границе с коллекторным переходом устанавливается близкой к нулю, так как дошедшие до коллекторного перехода под действием диффузии дырки ускоряются полем перехода и перебрасываются в коллектор. Установившееся при определенном напряжении Uэ (определенном токе эмиттера и соответствующей величине рn(0)) распределение концентрации дырок в базе показано на рис. 4.3, б.
Ввиду относительно малой толщины базового слоя lб (соизмеримой с диффузионной длиной дырок Lp) закон распределения концентрации дырок в базе при диффузии рn(х) близок к линейному. Градиент концентрации дырок в базе определяет диффузионный ток дырок в ней в направлении коллекторного перехода.
Описанный характер движения дырок в базе возможен только тогда, когда количество находящихся в объеме базы дырок равно количеству электронов, а распределения их концентраций близки (объемный заряд дырок скомпенсирован объемным зарядом электронов), т.е. при условии электрической нейтральности базы.
 Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений
Рис. 4.3. Транзисторная структура типа p-n-p (а), распределение концентраций носителей заряда (б), и внутренней разности потенциалов (в) при наличии внешних напряжений

 Следовательно, коэффициент передачи тока α тем ближе к 1, чем меньше отличаются от 1 коэффициент инжекции γ и коэффициент переноса δ. Способы приближения к 1 коэффициента передачи тока α связаны со способами увеличения коэффициентов γ и δ (увеличение разности концентраций основных носителей заряда в слоях эмиттера и базы, увеличение времени жизни дырок в базе, уменьшение ширины базового слоя, создание ускоряющего поля в слое базы).
Наличие коллекторного перехода, включенного в обратном направлении, приводит к появлению дополнительной неуправляемой составляющей тока коллектора, обусловленной протеканием обратного тока коллекторного перехода Iк0 (рис. 4.3, а). Как известно, обратный ток создается дрейфом неосновных носителей заряда из близлежащих областей обратно включенного p-n-перехода, в данном случае концентрациями дырок рn0 в базе и электронов nр0 в коллекторе (см. рис. 4.2, б).
Поскольку концентрации неосновных носителей заряда зависят от температуры, величина обратного тока также зависит от нее, поэтому этот ток часто называют тепловым. От величины тока эмиттера ток Iк0 не зависит.
Следовательно, коэффициент передачи тока α тем ближе к 1, чем меньше отличаются от 1 коэффициент инжекции γ и коэффициент переноса δ. Способы приближения к 1 коэффициента передачи тока α связаны со способами увеличения коэффициентов γ и δ (увеличение разности концентраций основных носителей заряда в слоях эмиттера и базы, увеличение времени жизни дырок в базе, уменьшение ширины базового слоя, создание ускоряющего поля в слое базы).
Наличие коллекторного перехода, включенного в обратном направлении, приводит к появлению дополнительной неуправляемой составляющей тока коллектора, обусловленной протеканием обратного тока коллекторного перехода Iк0 (рис. 4.3, а). Как известно, обратный ток создается дрейфом неосновных носителей заряда из близлежащих областей обратно включенного p-n-перехода, в данном случае концентрациями дырок рn0 в базе и электронов nр0 в коллекторе (см. рис. 4.2, б).
Поскольку концентрации неосновных носителей заряда зависят от температуры, величина обратного тока также зависит от нее, поэтому этот ток часто называют тепловым. От величины тока эмиттера ток Iк0 не зависит.
