
Студопедия КАТЕГОРИИ: АвтоАвтоматизацияАрхитектураАстрономияАудитБиологияБухгалтерияВоенное делоГенетикаГеографияГеологияГосударствоДомЖурналистика и СМИИзобретательствоИностранные языкиИнформатикаИскусствоИсторияКомпьютерыКулинарияКультураЛексикологияЛитератураЛогикаМаркетингМатематикаМашиностроениеМедицинаМенеджментМеталлы и СваркаМеханикаМузыкаНаселениеОбразованиеОхрана безопасности жизниОхрана ТрудаПедагогикаПолитикаПравоПриборостроениеПрограммированиеПроизводствоПромышленностьПсихологияРадиоРегилияСвязьСоциологияСпортСтандартизацияСтроительствоТехнологииТорговляТуризмФизикаФизиологияФилософияФинансыХимияХозяйствоЦеннообразованиеЧерчениеЭкологияЭконометрикаЭкономикаЭлектроникаЮриспунденкция |
ТЕРМИЧЕСКОЕ ОКИСЛЕНИЕ КРЕМНИЯСтр 1 из 2Следующая ⇒ Федеральное агентство по образованию Государственное образовательное учреждение высшего профессионального образования Ульяновский государственный технический университет
ФИЗИКО-ХИМИЧЕСКИЕ ОСНОВЫ ТЕХНОЛОГИИ ЭЛЕКТРОННЫХ СРЕДСТВ
Сборник лабораторных работ по дисциплине «Физико-химические основы технологии электронных средств»
Составитель В. И. Смирнов
Ульяновск 2006
УДК 621.38(076) Физико-химические основы технологии электронных средств … /. Сост. В. И. Смирнов. – Ульяновск: УлГТУ, 2006. – 22 с. Сборник лабораторных работ выполнен в соответствии с учебными программами дисциплины «Физико-химические основы технологии электронных средств». В сборнике представлены лабораторные работы, цель которых – изучение основных физико-химических процессов при формировании структур полупроводниковых интегральных микросхем, а именно, диффузии, ионной имплантации, термического окисления, катодного распыления. Работы имеют расчетный характер, в каждой из них даны список литературы и контрольные вопросы для самопроверки. Ил. 7. Табл. 2. Библиогр.: 7 назв.
Рецензент профессор кафедры АиАиРЭО Ульяновского высшего авиационного училища гражданской авиации, к.т.н. А. В. Ефимов
Одобрен секцией методических пособий научно-методического совета университета
© УлГТУ, 2006
СОДЕРЖАНИЕ Введение …………………………………………………………………….…….. 4 Лабораторная работа №1. Термическое окисление кремния ………….………. 5 Лабораторная работа №2. Диффузия ……………………………………….…… 9 Лабораторная работа №3. Ионная имплантация ………………………………. 13  Лабораторная работа №4. Катодное распыление ……………………………… 18 Приложение ………………………………………………………………………. 22
Введение
Сборник лабораторных работ по дисциплине «Физико-химические основы технологии электронных средств» для студентов, обучающихся по направлению 21020165, включает в себя описания четырех работ, цель которых – изучение физико-химических процессов при формировании структур полупроводниковых интегральных микросхем. Все работы носят расчетный характер и предполагают наличие у студентов навыков работы с компьютером, в частности, с программным пакетом MathCad. Перед выполнением работы студент обязан сдать допуск по работе и получить у преподавателя исходные данные для расчета. Отчет по работе, кроме названия, цели работы и основных расчетных соотношений, включает в себя также результаты расчета, оформленные в виде таблиц и графиков, и выводов по работе. Каждая из работ имеет список литературы и контрольные вопросы для самопроверки.
Лабораторная работа № 1. ТЕРМИЧЕСКОЕ ОКИСЛЕНИЕ КРЕМНИЯ
Цель работы 1. Изучение механизма окисления кремния. 2. Изучение модели Дила-Гроува. 3. Изучение влияния технологических факторов на скорость окисления. 4. Расчет скорости окисления кремния при различных температурах процесса.
Введение Оксидные пленки на поверхности кремния предназначены в основном для пассивации поверхности полупроводниковых пластин, формирования маскирующих покрытий при фотолитографии и формирования подзатворного слоя диэлектрика в МДП-структурах. Одним из основных способов получения пленок SiO2 является термическое окисление в сухом кислороде или смеси кислорода и паров воды. Соответствующие химические реакции для сухого и влажного окисления имеют вид: Реакция окисления происходит на границе раздела Si - SiO2, то есть атомы и молекулы окислителя диффундируют через растущий слой оксида к поверхности кремния, где и происходит реакция. Температура процесса находится в диапазоне 800-1300°С. Чем выше температура, тем выше скорость роста пленки SiO2. Однако проводить процесс окисления пластин Si при высоких температурах, когда в них уже сформированы элементы микросхемы, нежелательно, поскольку дополнительный нагрев приводит к процессу диффузии примесей, уже внедренных в пластину.
где h – коэффициент пропорциональности, называемый константой скорости растворения молекул окислителя в слое SiO2. Плотность потока молекул окислителя через растущий слой оксида кремния j2 определяется законом Фика: где D – коэффициент диффузии молекул окислителя в SiO2; z0 – толщина слоя SiO; С2 – концентрация молекул на границе раздела SiO2 – Si. Плотность потока j3, описывающая скорость химической реакции, пропорциональна концентрации молекул окислителя C2 у границы раздела где k – константа скорости химической реакции. В установившемся режиме все эти плотности потока равны: Исключив из этих равенств С1, получим: Для того, чтобы за время dt окислить объем или Следует учесть, что при влажном окислении в соответствии с химической реакцией на образование одного моля SiO2 требуется два моля H2O, поэтому величину Ni необходимо взять равной Разделяя переменные и интегрируя с учетом того, что в момент Упростим полученное выражение, введя новые обозначения: С учетом этого получим: Решая это квадратное уравнение, найдем зависимость толщины растущего слоя SiO2 от времени: При малых временах окисления, когда выполняется условие При большом времени окисления, когда выполняется условие Таким образом, на начальном этапе роста оксидной пленки ее толщина увеличивается со временем линейно, при большом времени окисления – зависимость корневая. Это качественно верно описывает кинетику роста оксидной пленки. Теоретически было доказано, что параметры A и B экспоненциально зависят от температуры: где С1, С2, E1, E2 – эмпирические коэффициенты, равные для сухого окисления: для влажного окисления: Толщину самородного слоя zi при сухом окислении в расчетах можно принять равной нулю, при влажном окислении Кроме температуры и окислительной среды на скорость роста слоя SiO2 влияет давление газа-окислителя. Повышение давления увеличивает концентрацию молекул окислителя, растворенных в приповерхностном слое, тем самым увеличивается градиент концентрации молекул в слое SiO2, а значит, и скорость диффузии. Окисление при повышенном давлении водяного пара (ускоренное гидротермальное окисление) позволяет получать оксидные пленки толщиной 2-3 мкм. Недостатком метода является необходимость использования герметичных и высокопрочных реакторов вместо технологичных проточных систем. Наиболее часто используется толщина оксидной пленки, составляющая десятые доли микрометра, а верхний практический предел по толщине для обычного термического окисления составляет 1-2 мкм. Значительное положительное влияние оказывает добавление в окислительную среду хлорсодержащих компонентов. Это привело к улучшению стабильности порогового напряжения МДП-транзисторов, увеличению напряжения пробоя и повышению скорости окисления. Главная роль хлора в пленках SiO2 (обычно с концентрацией хлора 1016 – 1020 см-3) заключается в превращении проникших в оксид примесных ионов, таких как Na и K, в электрически неактивные. Кроме того, внедрение хлора может создавать механические напряжения в решетке SiO2, вследствие чего облегчается диффузия молекул окислителя через оксидную пленку. На скорость роста слоя SiO2 оказывает влияние кристаллографическая ориентация кремниевой пластины. Окисление на пластине с ориентацией (111) происходит быстрее, чем с ориентацией (100). Влияние ориентации особенно заметно при относительно низких температурах. Так, например, при Т = 700 °С отличие в скорости окисления составляет 40 %, а при Т = 1200 °С всего 2 %. Зависимость скорости окисления от кристаллографической ориентации объясняется тем, что различным кристаллографическим направлениям пластины соответствует разное количество связей Si – Si. Большое влияние на скорость роста слоя SiO2 оказывает концентрация легирующей примеси в исходной пластине кремния. Это влияние обусловлено явлением сегрегации примеси на границе раздела SiO2 – Si. Для одних примесных атомов растворимость в Si выше, чем в SiO2, поэтому при термическом окислении растущий оксид оттесняет примесные атомы вглубь пластины кремния. В результате оксидный слой обедняется данными примесными атомами. Так, в частности, ведут себя атомы фосфора, мышьяка, сурьмы. А такие атомы, как бор, напротив, лучше растворяются в SiO2, чем в Si, поэтому при окислении слой SiO2 получается обогащенным атомами бора. Наличие примесных атомов в слое SiO2 создает в нем механические напряжения и как бы «разрыхляет» его, что способствует увеличению скорости диффузии молекул окислителя через растущий слой оксида. Атомы фосфора, мышьяка и сурьмы оказывают влияние только на скорость химической реакции. Поэтому их влияние существенно только на ранней стадии процесса, когда толщина слоя невелика и общая скорость окисления определяется скоростью химической реакции. Атомы бора, напротив, оказывают влияние и при относительно толстых слоях SiO2.
Задание 1. Получить у преподавателя исходные данные для расчета: окислительная среда, температуры процесса. 2. Рассчитать и построить графики зависимостей толщины оксидной пленки от времени окисления при различных температурах.
Контрольные вопросы 1. Механизм термического окисления (модель Дила-Гроува). 2. Влияние на скорость роста SiO2 температуры и давления газа-окислителя. 3. Влияние на скорость роста и качество пленок хлоросодержащих компонентов. 4. Влияние на скорость роста SiO2 концентрации примеси в кремнии и кристаллографической ориентации подложки.
Литература 1. Курносов А. И., Юдин В. В. Технология производства полупроводниковых приборов и интегральных микросхем. – М.: Высш. шк., 1986. – С. 112-120. 2. Пичугин И. Г., Таиров Ю. М. Технология полупроводниковых приборов. – М.: Высш. шк., 1984. – С. 236-269. 3. Броудай И., Мерей Дж. Физические основы микротехнологии. – М.: Мир, 1985. – С. 358-365. 4. Смирнов В. И. Физико-химические основы технологии электронных средств. Учебное пособие. – Ульяновск: УлГТУ, 2005. – С. 24- 29
Лабораторная работа № 2. ДИФФУЗИЯ Цель работы 1. Изучение закономерностей процесса диффузии 2. Изучение влияния различных факторов на скорость диффузии. 3. Расчет профиля распределения примеси и глубины залегания p-n перехода при различных технологических режимах.
Введение Диффузия представляет собой процесс движения примесных атомов в кристаллической решетке. В отличие от диффузии в газовой фазе перемещение атомов в кристалле осуществляется скачками. Эти скачки происходят во всех направлениях и суммарный поток определяется статистическим усреднением за определенный период времени. Атомы кристалла образуют пространственную периодическую структуру. Примесный атом, перемещаясь по кристаллу, постоянно перескакивает из одного устойчивого состояния в другое. Для того чтобы осуществился такой перескок, необходимо, чтобы атом получил от кристаллической решетки энергию, достаточную для преодоления потенциального барьера, удерживающего атом в устойчивом состоянии. Кроме этого, необходимо также, чтобы конечный пункт перескока примесного атома был свободен. Высота потенциального барьера, называемого энергией активации диффузии, для большинства материалов имеет значение 1 - 4 эВ, а расстояние между соседними потенциальными барьерами соответствует постоянной решетки и примерно равно 0,1 - 0,3 нм. Примесные атомы в кристалле могут перемещаться либо по вакансиям (свободным узлам кристаллической решетки), либо по междоузлиям. Соответственно этому различают два основных механизма диффузии: диффузия по вакансиям (диффузия замещения) и диффузия по междоузлиям (диффузия внедрения). Диффузия по междоузлиям происходит в сотни тысяч раз быстрее, чем диффузия по вакансиям. Это объясняется тем, что при диффузии по вакансиям необходимым условием является наличие вакансии вблизи диффундирующего атома, а это представляет собой относительно редкое событие, поскольку концентрация вакансий в кристалле невелика. При диффузии по междоузлиям такое условие несущественно, поскольку большинство междоузлий свободно. Реально имеет место комбинация этих двух механизмов, но один из них обычно преобладает. Примесные атомы III и V групп в кремнии диффундируют, как правило, по вакансиям, а атомы I и VIII – по междоузлиям. Закономерности диффузионных процессов описываются законами Фика, которые для одномерного случая имеют вид: Здесь j – плотность потока атомов диффузанта; c – концентрация примеси; D – коэффициент диффузии примеси, зависящей от температуры: где Ea – энергия активации диффузии; D0 – коэффициент диффузии при физически бесконечной температуре, т. е. при Решение уравнения диффузии позволяет рассчитать зависимость Случай 1. Диффузия из неограниченного источника. Граничные условия в этом случае имеют вид: где Решением уравнения диффузии в этом случае будет функция, описываемая выражением: где
Диффузия из неограниченного источника обычно соответствует первому этапу диффузии, задачей которого является введение в кристалл определенного количества примеси (так называемая загонка примеси), которое определяется дозой легирования Q. Доза легирования Q по определению равна числу атомов примеси, введенных в кристалл через единичную поверхность за все время диффузии. Ее можно найти из первого закона Фика: Интегрируя это выражение по времени, получим: Случай 2. Диффузия из ограниченного источника. В этом случае остается постоянным общее количество примеси, введенное в тонкий приповерхностный слой кристалла, т. е. Решением уравнения диффузии в этом случае будет функция Гаусса: Профили распределения примеси для этого случая показаны на рис.2.2. Здесь же пунктиром показана концентрация исходной примеси и глубина залегания p-n – перехода. Заштрихованный прямоугольник определяет дозу легирования Q. Глубину залегания p-n – перехода можно рассчитывать по формуле:
На скорость диффузии может оказать влияние и концентрация самой диффундирующей примеси. Это объясняется тем, что примесные атомы в процессе диффузии находятся в ионизированном состоянии. Возникающие при этом носители заряда (электроны в случае диффузии доноров), являясь более подвижными, чем ионы примеси, диффундируя вглубь подложки, создают электрическое поле, увлекая тем самым за собой ионы примеси. Этот дополнительный дрейф, увеличивающий эффективный коэффициент диффузии, проявляется лишь тогда, когда концентрация примеси существенно превышает собственную концентрацию носителей заряда в полупроводнике. Таблица 2.1.Параметры различных диффузиантов в Si.
Задание 1. Получить у преподавателя исходные данные для расчета: вид диффузанта, температура, условия процесса, концентрация примеси в приповерхностном слое, исходная концентрация примеси в подложке, доза легирования. 2. Рассчитать и построить графики зависимостей концентрации примесей от глубины в различные моменты времени. 3. В случае диффузии из ограниченного источника рассчитать глубину залегания p-n – перехода и сравнить это значение с полученным из графика.
Контрольные вопросы 1. Закономерности процесса диффузии (Законы Фика). 2. Механизмы диффузии в полупроводниках. Объяснить зависимость коэффициента диффузии от температуры. 3. Диффузия из ограниченного и неограниченного источников. 4. Влияние примеси и структурных дефектов на скорость диффузии.
Литература 1. Парфенов О. Д. Технология микросхем. – М.: Высш. школа, 1986. – С. 38-45. 2. Готра З. Ю. Технология микроэлектронных устройств. Справочник. – М.,: Радио и связь, 1991. – С. 149-172. 3. Пичугин И. Г., Таиров Ю. М. Технология полупроводниковых приборов. – М.: Высш. шк., 1984. – С. 179-210. 4. Смирнов В. И. Физико-химические основы технологии электронных средств. Учебное пособие. – Ульяновск: УлГТУ, 2005. – С. 31- 39
Лабораторная работа №3 ИОННАЯ ИМПЛАНТАЦИЯ
Цель работы 1. Изучение закономерностей формирования структур в полупроводниках методом ионной имплантации. 2. Расчет профиля распределения примесных атомов в кремнии и глубины залегания p-n – перехода.
Введение Ионная имплантация – процесс внедрения в твердотельную подложку ионизированных атомов с энергией достаточной для проникновения их в приповерхностные области подложки (от кило- до мегаэлектронвольт). Наиболее общим применением ионной имплантации является процесс ионного легирования материалов, так как технология ионной имплантации позволяет с высокой точностью управлять количеством легирующей примеси. Ионная имплантация характеризуется универсальностью и гибкостью процесса, что позволяет получать необходимые концентрации примеси в случаях, когда другие методы неприемлемы. Избирательность процесса легирования обеспечивается либо сканированием остросфокусированного ионного пучка по заданной программе, либо перемещением широкого ленточного пучка по предварительно маскированной поверхности. Маски при данном методе легирования могут быть изготовлены из фоторезистов, оксидов, нитритов и др. Процесс ионной имплантации может осуществляться при низких температурах (вплоть до комнатных). Ионы при движении в подложке сталкиваются с атомами подложки и выбивают их из своих узлов. В результате вдоль траектории движения имплантированных ионов образуются многочисленные вакансии и междоузельные атомы, то есть создаются радиационные дефекты. Когда плотность пучка ионов превышает некоторое критическое значение, может образоваться сплошной аморфный слой. В результате столкновений ионов с атомами мишени они теряют свою энергию и, в конечном итоге, останавливаются (обычно в междоузлиях). Для того чтобы внедренные таким образом атомы смогли выполнить свои функции доноров или акцепторов, их необходимо перевести из междоузлий в узлы кристаллической решетки. Это осуществляют с помощью термического отжига. Другой важной задачей отжига является устранение возникших радиационных дефектов и восстановление исходной кристаллической структуры. Температура и продолжительность отжига определяется тем, насколько сильно нарушена кристаллическая структура подложки. Глубина проникновения ионов и их профиль распределения в аморфной мишени зависят главным образом от массы и энергии ионов, а также материала мишени. Для монокристаллических мишеней дополнительное влияние оказывает ориентация направления движения ионов относительно атомных плоскостей мишени (эффект каналирования). В случае аморфной мишени, а также для кристаллической мишени в отсутствии эффекта каналирования, профиль распределения имплантированной примеси описывается функцией Гаусса:
где Q – доза легирования; Rp – средняя проекция пробега на направление первоначального движения ионов; ΔRp – среднеквадратичное отклонение длин пробегов. На рис. 3.1. показан профиль распределения примеси для аморфной мишени (сплошная линия) и для кристаллической мишени при наличии эффекта каналирования (пунктирная кривая). На графике также отмечена исходная концентрация Cисх примеси в мишени и глубина залегания p-n – перехода.
Рис. 3.1. Профиль распределения имплантированной примеси в мишени
Профиль распределения имеет максимум на глубине
Глубина залегания p-n – перехода определяется выражением:
При извлечении корня следует учитывать оба знака, так как в объеме полупроводника возможно одновременное образование двух p-n – переходов. Величина ΔRp, зависящая от соотношения молярных масс имплантированный ионов примеси M1 и атомов мишени M2, может быть приблизительно оценена по формуле:
Теория пробегов ионов в аморфной и кристаллической мишенях была построена Линдхардом, Шарфом и Шиоттом и получила название теории ЛШШ. Согласно этой теории ион при движении в мишени теряет свою энергию в основном за счет двух механизмов: соударений с ядрами вещества мишени и взаимодействия с электронами (как связанными, так и свободными). В первом приближении считается, что оба вида потерь не зависят друг от друга и действуют одновременно. Тогда потеря энергии ионов на единице длины пробега:
где Sn и Se – ядерная и электронная тормозные способности соответственно; N – концентрация атомов мишени (для кремния
где E0 – начальная энергия иона. Согласно теории ЛШШ для кремния ядерную тормозную способность Sn можно рассчитать по формуле:
где z1, z2, M1 и M2 – порядковые номера и молярные массы для имплантируемых ионов и атомов мишени соответственно.
Рис. 3.2. Теоретические кривые для ядерной Sn и электронной Se тормозной способностей
Электронная тормозная способность Se в первом приближении пропорциональна скорости ионов V и, следовательно:
где коэффициент пропорциональности k для кремния может быть рассчитан по формуле:
Теоретические кривые для Sn и Se, полученные в рамках теории ЛШШ, представлены на рис. 3.2. При некоторой энергии Ec, называемой критической, ядерная и тормозная способность совпадают, на основании чего:
Отсюда для мишени из кремния:
Расчеты по этой формуле для различных примесей дают следующее:
Если энергия ионов меньше Ес, то преобладающий механизм торможения ядерный, если энергия ионов превышает Ес, то преобладает электронный механизм. Радиационные дефекты в подложке создаются, главным образом, при Sn >> Se. Поэтому при имплантации ионов, обладающих малыми энергиями, радиационные дефекты в подложке образуются вдоль всей траектории, а при высоких энергиях ионов – только в конце их пробега. Величину R можно вычислить по формуле:
где
(величина N выражена в нм-3). С точки зрения практического использования наиболее важное значение имеет не полный пробег R, а проекция пробега Rp на направление первоначальной траектории движения иона. Именно она определяет глубину залегания примеси. Теоретически было показано что
ЗАДАНИЕ 1. Получить у преподавателя исходные данные для расчета: материал мишени, вид ионов, энергию ионов, дозу облучения, исходную концентрацию примеси в мишени. 2. Рассчитать и построить график профиля распределения примеси по глубине. 3. Определить глубину залегания p-n – перехода.
КОНТРОЛЬНЫЕ ВОПРОСЫ 1. Сущность метода ионного легирования полупроводников. 2. Основные положения теории Линдхарда-Шарфа-Шиотта. Ядерное и электронное торможение, их зависимость от энергии ионов. 3. Распределение имплантированной примеси по глубине. Эффект каналирования. 4. Отжиг радиационных дефектов.
ЛИТЕРАТУРА 1. Черняев В. Н. Физико-химические процессы в технологии РЭА. – М.: Высш. шк., 1987. – С. 262-274. 2. Готра З. Ю. Технология микроэлектронных устройств: Справочник. – М.: Радио и связь, 1991. – С. 231-244. 3. Бродуай И., Мерей Дж. Физические основы микротехнологии. – М.: Мир, 1985. – С. 370-387. 4. Смирнов В. И. Физико-химические основы технологии электронных средств. Учебное пособие. – Ульяновск: УлГТУ, 2005. – С. 39- 44
Лабораторная работа №4. КАТОДНОЕ РАСПЫЛЕНИЕ
Цель работы 1. Изучение механизма распыления поверхности мишени потоком ионов. 2. Расчет зависимости коэффициента распыления кремния от энергии ионов примеси.
Введение Катодное распыление представляет собой один из ионно-плазменных методов получения тонких пленок. Распыляемая мишень является катодом в камере, где создается самостоятельный тлеющий разряд. Образующиеся при этом ионы газа (обычно инертного) бомбардируют поверхность мишени, распыляемые атомы осаждаются на подложку. Для описания процессов физического распыления используют модели, основанные на двух механизмах. Согласно первому механизму распыленные атомы возникают в результате сильного локального разогрева поверхности мишени самим падающим ионом (модель “горячего пятна”) или быстрой вторичной частицей (модель “теплового клина”). Второй механизм состоит в передаче импульса падающего иона атомам решетки материала мишени, которые, в свою очередь, могут передавать импульс другим атомам решетки, вызвав тем самым каскад столкновений (модель столкновений). В случае, когда поверхностный атом получит энергию, достаточную для разрыва связи с ближайшими соседями, и импульс будет направлен в сторону паровой фазы, атом перейдет в паровую фазу. При этом направление полета атома должно соответствовать направлению полученного им импульса. Очевидно, что при нормальном падении ионного пучка на мишень распыление может происходить только при последовательных вторичных столкновениях.
Основной характеристикой эффективности процесса распыления является коэффициент распыления Кр, определяемый отношением количества выбитых атомов Nат к количеству бомбардирующих мишень ионов Nион: По существу коэффициент распыления представляет собой среднее число атомов мишени, выбитых одним ионом.
Рис. 4.1. Зависимость коэффициента распыления металлов от энергии ионов.
Коэффициент распыления зависит от энергии иона, его массы (рода рабочего газа), материала мишени и, в некоторой степени, от ее температуры и состояния поверхности, а также от угла падения и давления газа в газоразрядной камере. Он увеличивается с ростом энергии и достигает насыщения (возможно даже с последующим снижением) при энергиях порядка нескольких десятков килоэлектронвольт, так как увеличение глубины проникновения ионов в мишень не сопровождается соответствующим ростом потерь энергии ионов вблизи ее поверхности. На рис. 4.1. представлены зависимости коэффициента распыления от энергии ионов для различных материалов мишени. Зависимость коэффициента распыления от температуры, как правило, невелика и носит сложный характер. Она определяется процессами, изменяющими структуру мишени при ее нагреве. Если при нагреве происходит отжиг дефектов, восстанавливающий кристаллическую структуру решетки, то коэффициент распыления уменьшается. Если структурных изменений не происходит, то коэффициент распыления может незначительно увеличиваться. Зависимость коэффициента распыления от угла падения носит немонотонный характер с максимумом в диапазоне углов от 30˚ до 60˚. При нормальном падении Kр пропорционален энергии, рассеиваемой ионом в приповерхностном слое вещества, в пределах которого упругие столкновения с атомами приводят к распылению. С увеличением угла падения число смещенных атомов, достигающих поверхности и способных покинуть кристалл, увеличивается, так как область смещений располагается под малым углом к поверхности (рис. 4.2). Увеличение угла от 60˚ до 90˚ приводит к падению коэффициента распыления до нуля вследствие преобладания отражения ионов от поверхности. Увеличение давления рабочего газа повышает вероятность столкновения распыленных атомов с молекулами газа, в результате чего часть атомов рассеивается в объеме камеры или возвращается на мишень, снижая тем самым коэффициент распыления. Присутствие в газоразрядной камере помимо основного инертного газа других газов (фоновая атмосфера) может уменьшить коэффициент распыления из-за образования на поверхности мишени химических соединений (оксидов, нитридов и т. д.).
Рис. 4.2. Модель распыления, объясняющая зависимость коэффициента распыления от угла бомбардировки.
Согласно модели, описывающей механизм катодного распыления, коэффициент распыления для изотропных мишеней определяется выражением:
Здесь E – энергия бомбардирующих мишень ионов; N – концентрация атомов мишени. Коэффициент K0 зависит от заряда ядра бомбардирующих ионов z1 и атомов мишени z2 и периодически изменяются с изменением z2: при
при
Концентрацию атомов мишени N можно рассчитать по формуле:
где ρ и М – плотность и молярная масса материала мишени соответственно; NA – число Авогадро. Сечение экранирования
Нормирующий коэффициент энергии F определяется по формуле:
где M1 и M2 – молярные массы бомбардирующих ионов и атомов мишени соответственно. Em – это энергия соответствующая максимуму в зависимости K(E). Она связана с нормирующим коэффициентом энергии F соотношением
Таблица 4.1. Энергия сублимации для некоторых металлов
ЗАДАНИЕ 1. Получить у преподавателя исходные данные для расчета: материал мишени, тип ионов. 2. Рассчитать зависимость коэффициента распыления мишени от энергии ионов. 3. Определить энергию, соответствующую максимуму зависимости K(E).
КОНТРОЛЬНЫЕ ВОПРОСЫ 1. Сущность метода катодного распыления. 2. Объяснить процесс образования газоразрядной плазмы. 3. Объяснить зависимость коэффициента распыления от различных технологических факторов (тип и энергия ионов, материал мишени, угол бомбардировки, температура, давление газа). 4. Ионно-плазменные методы получения тонких пленок (высокочастотное, магнетронное, реактивное распыление).
ЛИТЕРАТУРА 1. Курносов А. И., Юдин В. В. Технология производства полупроводниковых приборов и интегральных микросхем. – М.: Высш. шк., 1986. – С. 238-246. 2. Черняев В. Н. Физико-химические процессы в технологии РЭА. – М.: Высш. шк., 1987. – С. 212-230. 3. Парфенов О. Д. Технология микросхем. – М.: Высш. шк., 1986. – С. 209-225. 4. Смирнов В. И. Физико-химические основы технологии электронных средств. Учебное пособие. – Ульяновск: УлГТУ, 2005. – С. 79- 89
Приложение |
|||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Последнее изменение этой страницы: 2018-05-10; просмотров: 452. stydopedya.ru не претендует на авторское право материалов, которые вылажены, но предоставляет бесплатный доступ к ним. В случае нарушения авторского права или персональных данных напишите сюда... |


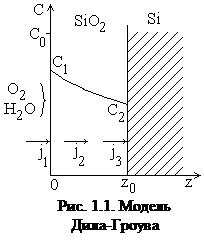 Кинетика процесса описывается моделью Дила-Гроува. Согласно этой модели, механизм окисления можно представить в виде нескольких стадий: адсорбции и растворения молекул окислителя в приповерхностном слое кремниевой пластины, диффузии их через растущий оксидный слой к границе раздела
Кинетика процесса описывается моделью Дила-Гроува. Согласно этой модели, механизм окисления можно представить в виде нескольких стадий: адсорбции и растворения молекул окислителя в приповерхностном слое кремниевой пластины, диффузии их через растущий оксидный слой к границе раздела  , химической реакции молекул окислителя с атомами кремния. Каждой из этих стадий можно поставить в соответствие плотность потока (рис. 1.1), которая по определению равна количеству молекул окислителя, пересекающих единицу поверхности за единицу времени. Плотность тока j1 определяется разностью концентраций молекул окислителя в газовой фазе C0 и приповерхностном слое пластины C1:
, химической реакции молекул окислителя с атомами кремния. Каждой из этих стадий можно поставить в соответствие плотность потока (рис. 1.1), которая по определению равна количеству молекул окислителя, пересекающих единицу поверхности за единицу времени. Плотность тока j1 определяется разностью концентраций молекул окислителя в газовой фазе C0 и приповерхностном слое пластины C1: ,
, ,
, :
: ,
, .
. .
. , требуется
, требуется  молекул. С другой стороны, это число равно
молекул. С другой стороны, это число равно  молекул, где Ni – концентрация атомов кремния в слое SiO2 (равная
молекул, где Ni – концентрация атомов кремния в слое SiO2 (равная  ). Отсюда:
). Отсюда:
 .
. .
. на поверхности кремния уже существовал самородный слой оксида толщиной zi, получим:
на поверхности кремния уже существовал самородный слой оксида толщиной zi, получим: .
.


 .
. .
. , получим:
, получим: .
. :
: .
.
 ,
,

 ;
;  ;
;

 ;
;  .
. .
. - 1-й закон Фика,
- 1-й закон Фика, - 2-й закон Фика.
- 2-й закон Фика. ,
, . Значение энергии активации Ea, коэффициента диффузии D0, а также коэффициента диффузии D при
. Значение энергии активации Ea, коэффициента диффузии D0, а также коэффициента диффузии D при  приведены в таблице 2.1. Если коэффициент диффузии не зависит от координаты, то 2-й закон Фика, называемый уравнением диффузии, примет вид:
приведены в таблице 2.1. Если коэффициент диффузии не зависит от координаты, то 2-й закон Фика, называемый уравнением диффузии, примет вид: .
. и тем самым определить профиль распределения примеси по глубине в различные моменты времени. Результат решения зависит от граничных условий. С практической точки зрения интерес представляют два случая, отличающихся заданием граничных условий: диффузия из неограниченного источника и диффузия из ограниченного источника.
и тем самым определить профиль распределения примеси по глубине в различные моменты времени. Результат решения зависит от граничных условий. С практической точки зрения интерес представляют два случая, отличающихся заданием граничных условий: диффузия из неограниченного источника и диффузия из ограниченного источника. = const;
= const;  ,
, - концентрация примеси в приповерхностном слое полупроводника.
- концентрация примеси в приповерхностном слое полупроводника. ,
, - дополнительная функция ошибок, равная по определению:
- дополнительная функция ошибок, равная по определению: .
. Значения этой функции протабулированы. Профили распределения примеси по глубине для этого случая представлены на рис. 2.1. Здесь же пунктиром показана концентрация исходной примеси, противоположной по типу вводимой примеси.
Значения этой функции протабулированы. Профили распределения примеси по глубине для этого случая представлены на рис. 2.1. Здесь же пунктиром показана концентрация исходной примеси, противоположной по типу вводимой примеси. .
. .
. =conct;
=conct;  .
. .
. .
. Существенное влияние на скорость диффузии кроме температуры оказывают атомы примеси и другие дефекты, присутствующие в кристалле. Локальная деформация решетки вблизи примесного атома приводит к уменьшению энергии связи между соседними атомами, что увеличивает вероятность образования вакансий. При вакансионном механизме диффузии это приводит к увеличению скорости диффузии. Энергия активации процесса диффузии может изменяться также вследствие кулоновского взаимодействия между атомами диффузианта и присутствующей в решетке примеси. Так наличие акцепторной примеси в кристалле ускоряет, а наличие донорской примеси замедляет процесс диффузии донорных атомов.
Существенное влияние на скорость диффузии кроме температуры оказывают атомы примеси и другие дефекты, присутствующие в кристалле. Локальная деформация решетки вблизи примесного атома приводит к уменьшению энергии связи между соседними атомами, что увеличивает вероятность образования вакансий. При вакансионном механизме диффузии это приводит к увеличению скорости диффузии. Энергия активации процесса диффузии может изменяться также вследствие кулоновского взаимодействия между атомами диффузианта и присутствующей в решетке примеси. Так наличие акцепторной примеси в кристалле ускоряет, а наличие донорской примеси замедляет процесс диффузии донорных атомов.

 при
при 






 ,
,
 , причем концентрация ионов в максимуме равна:
, причем концентрация ионов в максимуме равна: .
. .
. .
. ,
, ). Расстояние, которое ион пройдет до полной остановки, двигаясь по ломаной прямой, на основании предыдущей формулы равно:
). Расстояние, которое ион пройдет до полной остановки, двигаясь по ломаной прямой, на основании предыдущей формулы равно: ,
, ,
,
 ,
, .
. .
. .
. для
для  ;
; для
для  ;
; для As и Sb.
для As и Sb. ,
,
 ,
,

 , где
, где  для торможения на ядрах. В случае торможения на электронах коэффициент b меньше, однако множитель 1/3 в первом приближении остается в силе.
для торможения на ядрах. В случае торможения на электронах коэффициент b меньше, однако множитель 1/3 в первом приближении остается в силе.


 .
.
 см,
см,
 см.
см.
 , где a – радиус экранирования, рассчитываемый по формуле:
, где a – радиус экранирования, рассчитываемый по формуле: см.
см.
 ,
, . Энергия сублимации
. Энергия сублимации  для ряда элементов приведена в таблице 4.1.
для ряда элементов приведена в таблице 4.1.